Strained silicon technology: Non-destructive nanoscale characterization through Tip-enhanced Raman Spectroscopy
Résumé
The semiconductor industry is undergoing a transformative phase, marked by the relentless drive for miniaturisation and constant demand for higher performance and energy efficiency. However, the reduction of Metal-Oxide-Semiconductor Field-Effect Transistor (MOSFET) sizes for advanced technology nodes below 10 nm presents several challenges. In response, strained silicon technology has emerged as a key player, exploiting strain induction in the silicon crystal lattice to improve device performance. At the same time, there has been a growing need for characterization techniques that allow in-line monitoring of sample conditions during semiconductor manufacturing, as an alternative to traditional methods such as Transmission Electron Microscopy (TEM) or High Resolution X-Ray Diffraction (HRXRD), which have several limitations in terms of measurement time and sample destructiveness. This paper explores the application of advanced spectroscopic characterization techniques, in particular μ-Raman spectroscopy and TipEnhanced Raman Spectroscopy (TERS), to meet the evolving needs of the semiconductor industry for quality control and failure analysis, increasingly requiring faster and non-destructive characterization techniques. μ-Raman provides insight into strain values and distributions
Fichier principal
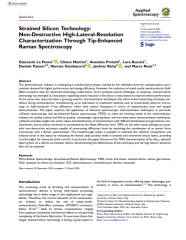 La Penna 2024 - Strained Silicon Technology Applied Spectroscopy.pdf (1.64 Mo)
Télécharger le fichier
La Penna 2024 - Strained Silicon Technology Applied Spectroscopy.pdf (1.64 Mo)
Télécharger le fichier
| Origine | Fichiers produits par l'(les) auteur(s) |
|---|
